

325nmレーザ励起フォトルミネッセンス測定装置 |
||||||||||||
 |
||||||||||||
|
フォトルミネッセンス(Photoluminescence, PL)法とは、物質に光を照射して電子を励起し、
その励起電子が基底状態へ遷移する際に放出される光(ルミネッセンス)を分光・検出することにより、
材料中の電子状態や欠陥、不純物レベルを非破壊で評価する手法です。発光スペクトルのエネルギー位置や強度、
スペクトル幅などの解析を通じて、材料のバンド構造、格子の完全性、微量不純物分布などを把握することができます。 本装置は、高安定出力のHe-Cdレーザー(325 nm)を励起光源として搭載しており、 バンドギャップが最大約3.5 eV以下の半導体材料に対して有効な励起が可能です。紫外波長の励起光により、 GaNなどのワイドギャップ半導体にも対応しています。 測定によって以下のような情報を取得できます:
|
||||||||||||
■仕様 |
||||||||||||
|
||||||||||||
■GaNテンプレートのPLスペクトラム |
||||||||||||
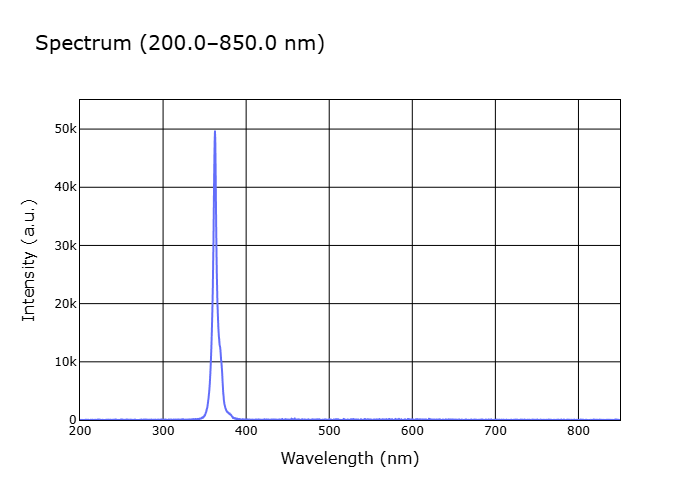 |
||||||||||||
※本仕様および外観は改善のため予告無く変更することがあります。 |
||||||||||||
■フォトルミネッセンス(Photoluminescence, PL)の基本原理 |
||||||||||||
|
フォトルミネッセンス(PL)は、物質に高エネルギーの光(励起光)を照射することで、価電子帯に存在していた電子が励起され、伝導帯などの高エネルギー準位に遷移した後、再び基底準位へ戻る過程において放出される光(フォトン)を検出・解析する光学的手法です。この現象は、主に半導体材料や蛍光体などにおける電子状態の評価や材料品質の診断に広く利用されます。 図に示すように、基底準位(多くの場合は価電子帯上端)にある電子は、外部から照射される励起光のエネルギーを吸収し、より高いエネルギー準位(典型的には伝導帯)に励起されます。これにより、電子と正孔の対が形成されます。
しかしながら、励起された電子は即座に再結合して放射遷移を起こすとは限りません。多くの場合、再結合に至る前に、以下に示すような緩和機構を経由することがあります。
このような過程により、PL測定で観測される発光スペクトルは、必ずしも入射光子のエネルギーとバンドギャップのエネルギー差をそのまま反映するわけではなく、物質内部における多様な緩和経路の影響を受けることになります。 PLは、試料に非接触・非破壊で適用できる高感度な評価手法であり、バンド構造やエネルギー準位の解析に加え、結晶性、欠陥密度、不純物分布などの情報を包括的に取得可能です。特に半導体デバイスの材料開発や品質管理、量子ドット・低次元構造の評価において重要な技術として位置づけられています。 |